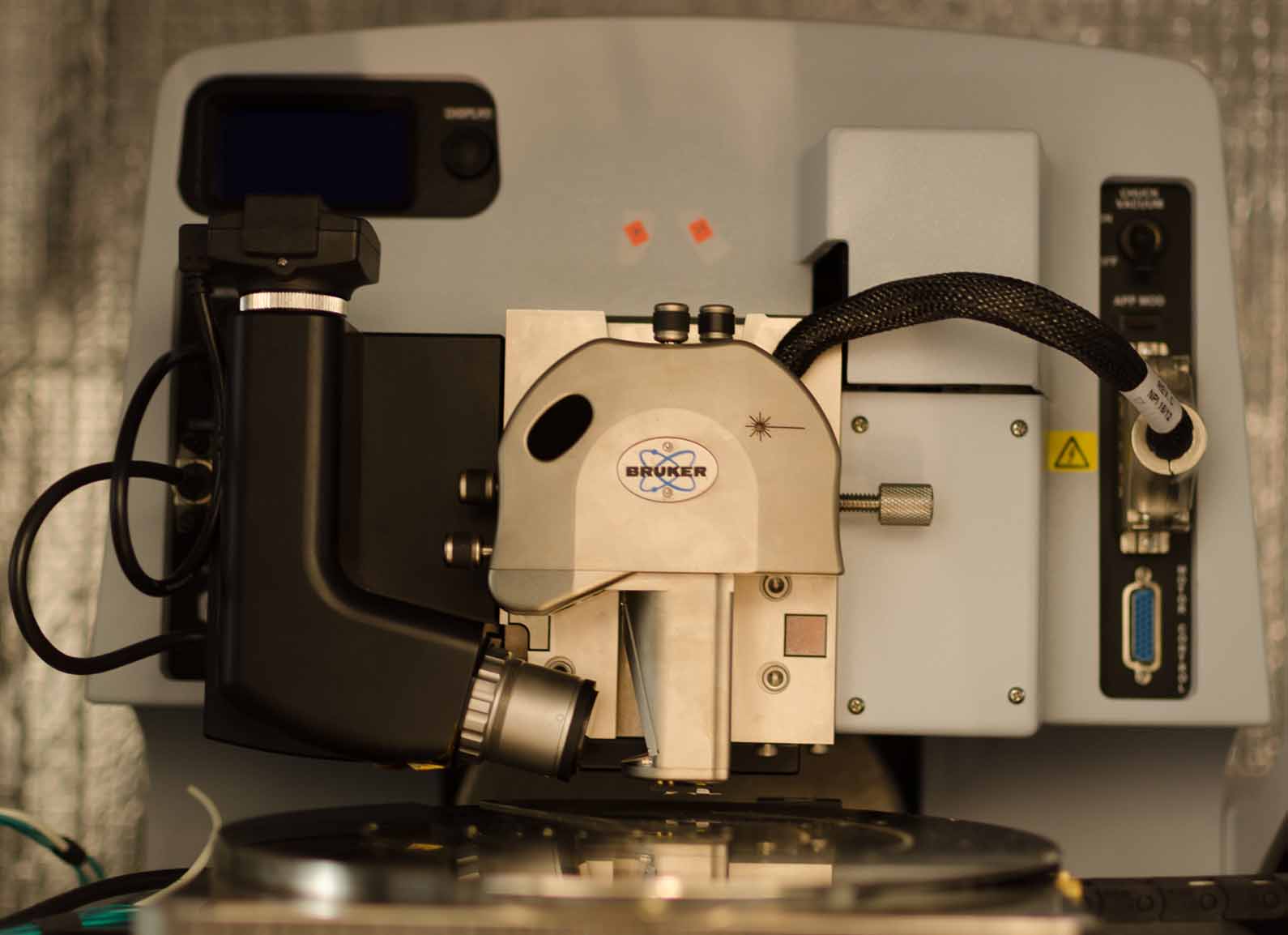
Mikroskopia ze skanującą sondą SPM to wspólna nazwa rodziny technik mikroskopowych, których cechą charakterystyczną jest to, że do skanowania powierzchni próbki wykorzystywana jest sonda skanująca. Dwa podstawowe rodzaje SPM to skaningowa mikroskopia tunelowa (STM) i mikroskopia sił atomowych (AFM). Technika SPM zapewnia możliwość uzyskiwania informacji o topologii (ale także właściwościach mechanicznych, elektrycznych, magnetycznych) w skali od mikrometrów do ułamków nanometrów.
Zasada działania Skaningowego Mikroskopu Tunelowego bazuje na efekcie tunelowym, a więc przepływie prądu tunelowego kiedy sonda zbliży się odpowiednio blisko powierzchni próbki. Gdy sonda przemieszcza się po powierzchni próbki zmienia się jej topografia a więc również i prąd tunelowy. Pętla sprzężenia zapewniając stały prąd tunelowy utrzymuje stałą odległość między sondą a próbką. STM może być stosowany wyłącznie do próbek przewodzących.
Techniką znacznie bardziej odpowiednią do badań dielektryków jest mikroskopia sił atomowych, która do obrazowania powierzchni z rozdzielczością sięgającą rzędu kilku nanometrów wykorzystuje sondę w postaci ostrza umieszczonego na płaskiej dźwigience. Technika AFM bazuje na wykorzystywaniu oddziaływań międzyatomowych. Trzy podstawowe tryby pracy AFM to:
- tryb kontaktowy
- tryb bezkontaktowy
- tryb z przerywanym kontaktem
Oprócz informacji na temat topologii technika ta może być również rozszerzona, tak aby umożliwić uzyskanie wielu ciekawych informacji o wł. powierzchni badanych materiałów biologicznych i nie-biologicznych (ciał stałych, ale również cieczy), są to m.in.
- wł. magnetyczne, wtedy tzw. mikroskopia sił magnetycznych (ang. Magnetic Force Microscopy)
- charakterystyka wł. mechanicznych takich jak tarcie, adhezja, chropowatość, sprężystość. Służą do tego np. mikroskopia z modulacją siły (ang. Force Modulation Microscopy), mikroskopia z detekcją fazy (ang. Phase Detection Microscopy), boczna mikroskopia siłowa (ang. Lateral Force Microscopy)
- wł. elektrostatycznych, tzw. Mikroskopia Sił Elektrostatycznych (ang. Electrostatic Force Microscopy)
- zmiany przestrzenne w pojemności elektrycznej badanych układów, tzw. Mikroskopia Pojemnościowa (ang. Scanning Capacitance Microscopy)
- wł. elektryczne nanostruktur, tzw. Mikroskopia Sił Atomowych z Przewodzącą Sondą (ang. Conductive AFM)
Mikroskop Sił Atomowych Icon Bruker
Dostępne tryby pracy - ScanAsyst (w cieczy i powietrzu), Tapping Mode (w cieczy i powietrzu), Contact Mode (w cieczy i powietrzu), Lateral Force Microscopy, PhaseImaging, Lift Mode, MFM, Force Spectroscopy, PeakForce Tuna, Force Volume, EFM, Surface Potential, Piezoresponse Microscopy, Force Spectroscopy, PeakForce QNM.
Przykłady:

Topografia wysp niklowych na podłożu krzemowym
 (b)
(b)


Nanoindenter
Nanoindenter to urządzenie do badania własności mechanicznych materiałów w skali nanometrowej. Jako przykładowe wielkości wyznaczane tym urządzeniem można wyróżnić: moduł Younga, twardość, współczynnik tłumienia drgań a co dalej z tego wynika można określić podatność na zarysowania, podatność na zużycie wskutek tarcia, bardzo małe ugięcia pod wpływem przyłożonej siły.
Ponadto posiada on również możliwość obrazowania (skanowania na zasadzie SPM) dzięki której można uzyskanć obraz topografii przed indentacją, wybranie miejsca wykonania indentu z dokładnością 10 nm, a następnie ponowne wykonanie obrazu topografii tego samego obszaru po indentacji
Ważniejsze parametry:
- zakres ruchu XY co najmniej 240 x 120 mm,
- zakres ruchu Z co najmniej 40 mm,
- rozdzielczość 700 nm,
- maksymalne przesunięcie normalne co najmniej 5 um,
- rozdzielczość przesunięcia normalnego 0,02 nm,
- rozdzielczość rzeczywista (Noise Floor) 0,2 nm,
- możliwość pracy zarówno w powietrzu jak i w cieczy,
- pomiar amplitudy, fazy, sztywności kontaktowej i współczynnika tłumienia,
- tworzenie map odpowiedzi wiskoelastycznych (tłumienie, sztywność).
- badanie rozkładu modułu Younga na powierzchni badanej próbki (maping) z wykorzystaniem modułu pomiarowego nanoDMA






